|
|
引言
- J |: n0 Y5 HCu-Cu混合键合(Cu-Cu Hybrid Bonding) 技术正在成为先进3D集成的重要技术,可实现细间距互连和高密度芯片堆叠。本文概述了Cu-Cu混合键合的原理、工艺、主要挑战和主要行业参与者的最新进展[1]。2 e3 f- G7 y' q# I& x
P1 I: @$ v! M1 r5 q y
Cu-Cu混合键合技术简介8 d& J% W) [ r' I0 ^) G) T" d
Cu-Cu混合键合是芯片堆叠技术,结合了Cu-Cu金属键合和介电-介电键合,通常是氧化物-氧化物键合。工艺通常包括以下关键步骤:对Cu焊盘和介电表面进行化学机械抛光(CMP)表面活化,通常使用等离子体处理 介电表面在室温下键合退火以促进Cu-Cu互扩散并形成强金属键
0 z. v3 M7 [1 s+ g: E+ D: [[/ol]
3 l* o; d0 |' R7 h) @' U与使用焊料凸点的传统倒装芯片键合相比,Cu-Cu混合键合具有以下优势:
# x" O' M8 M* q3 ]/ ]- D0 a8 }更细的间距(亚微米)互连更低的寄生电容和电阻更好的散热性能更薄的封装厚度
' k( a" F- S' ]; v/ _! c* a# P, B* _4 G
, t- O1 d2 J8 ]7 t1 ^( p$ ^" ?
qaktyx5h1ap64077135536.png
 0 k4 a# G: u$ e" H
0 k4 a# G: u$ e" H
图1:(a)倒装芯片焊料回流和(b)Cu-Cu混合键合的16H HBM结构对比。混合键合方法实现了更薄的封装,芯片之间无间隙连接。# W7 t- A' [( `& L' }
+ O e0 _+ w/ z; Y8 y1 u k
关键工艺步骤和挑战9 ~& A9 W2 W6 O5 H0 G9 P; B& T
表面准备/ F/ L- i6 ?) b5 l. t
获得超平滑和清洁的键合表面对成功实现混合键合很重要。化学机械抛光(CMP)用于使Cu焊盘和介电表面平坦化。精确控制Cu凹陷(凹陷)很重要 - 通常只允许几纳米的凹陷。
& `6 E# f7 I' p# z8 a! {
tukrj3e12yu64077135636.png

% {2 @$ X, ?1 j! U1 I图2:使用SiCN作为键合层的晶圆对晶圆混合键合集成流程。CMP用于在键合前使表面平坦化。4 ~# N& S) {" p. f: |
! {2 y2 |1 L N, p表面活化
2 K# o2 F& i6 I; W1 I2 j; B等离子体处理通常用于在键合前活化介电表面。这在表面上创建反应性羟基(OH)基团,以实现室温键合。需要优化等离子体条件以获得高键合强度。8 W3 r0 Z! `7 E. @
itbdsj3iifp64077135737.png
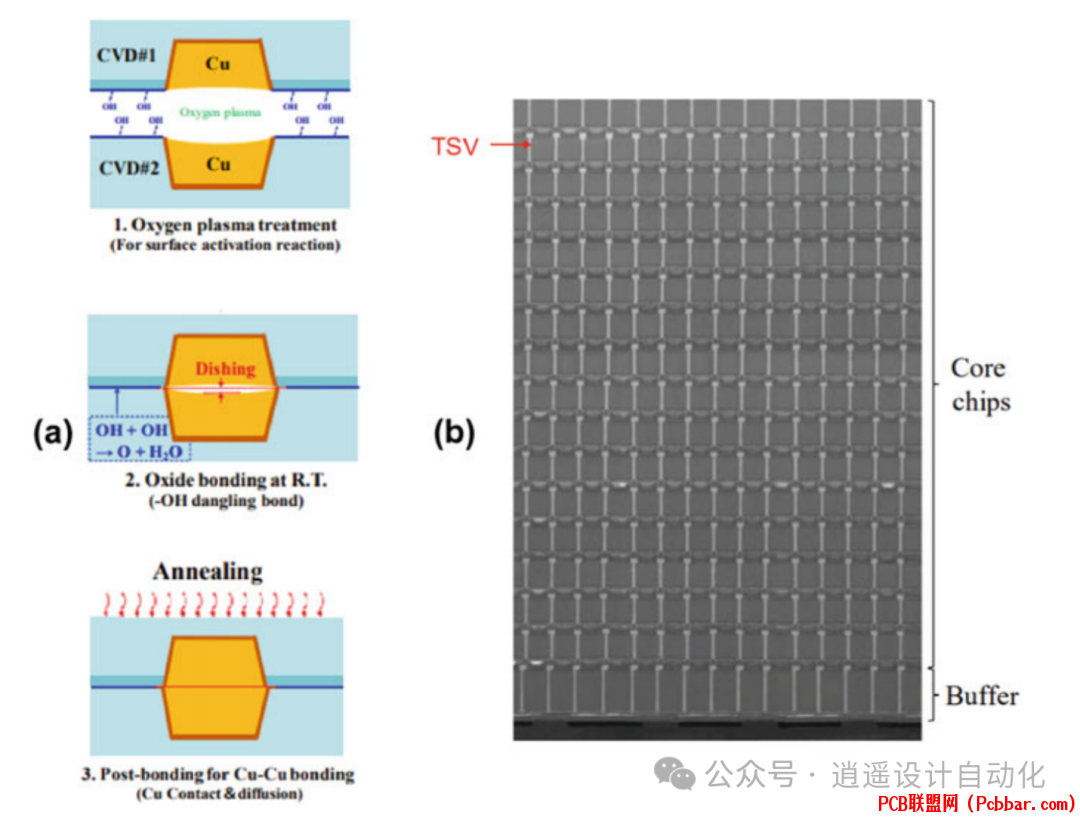
, {) t5 N/ |' _% ?$ d图3:关键的混合键合工艺步骤,包括通过等离子体处理进行表面活化,以创建羟基基团实现室温键合。% h; S- V1 o8 i& |3 y; `
- T. ^; g# D- i8 ^! Q+ r室温键合
( L1 l; }- h# W$ {6 S将活化的晶圆或芯片在室温下接触,使介电表面形成初始键合。精确对准对细间距互连尤为关键。$ @) F9 [- V4 d" g
1 j) h9 Q5 N6 Q) `/ V7 ], P
退火8 Y) Z7 N3 j0 s. ~6 F
键合后退火,通常在200-400°C下进行,使Cu原子能够跨键合界面扩散,形成强金属-金属键。需要优化退火条件,以实现良好的Cu键合,同时避免空洞形成等问题。
. ~3 }/ V9 H4 h) q9 H% I3 z( r5 {
2k3pylmuxfd64077135837.png
 ( T" B% l7 m' p- J# F
( T" B% l7 m' p- J# F
图4:(a)16H HBM整体结构和(b)退火后Cu-Cu界面的横截面SEM图像,显示跨键合界面的重结晶Cu晶粒。/ m) H/ q. L2 ^# \; X
1 f( f( w S& @0 n) P
主要挑战 i0 b5 b* Y7 e3 s0 L& f- P& O
Cu-Cu混合键合的主要挑战包括:实现并维持超清洁的键合表面精确控制Cu凹陷/凹陷 优化等离子体活化以获得高键合强度精确对准,特别是对于细间距键合界面处的空洞/缺陷控制某些应用的热预算限制
% F' Q/ @% `! E- C[/ol]
* {7 b7 Q) h- M, y$ q/ u
/ s; H! {$ i7 h主要参与者的最新进展$ @( ?0 j. M9 K* z% i5 T! Y X
三星5 m Y7 J& `# W
三星一直在积极开发用于高带宽内存(HBM)应用的混合键合技术。已经展示了使用混合键合的16H HBM堆叠。
9 A5 Q4 x8 i& g
ymqqivsk1yh64077135937.png

1 e$ |7 I1 I I( G! x/ U8 I6 o& S图5:使用TCB-NCF和混合键合方法的16H HBM堆叠热阻对比。混合键合方法显示出15-30%较低的热阻。: x8 k5 b8 c' W! J
5 _: k w4 @5 U# x8 K& {# v9 b0 N
三星还提出了新型结构,如键合界面处的Cu-Cu布线,以进一步改善电气和热性能。
: n z& J) ]$ q. _6 @1 M" y; i2 n
SK海力士
R$ ` w+ Q, M/ |# `3 OSK海力士也在追求用于HBM的混合键合。已经展示了使用芯片对晶圆(C2W)混合键合的8Hi HBM堆叠。
2 Z+ Z d. O s) J6 C! ?/ s6 B
404qyu3vlvd64077136038.png
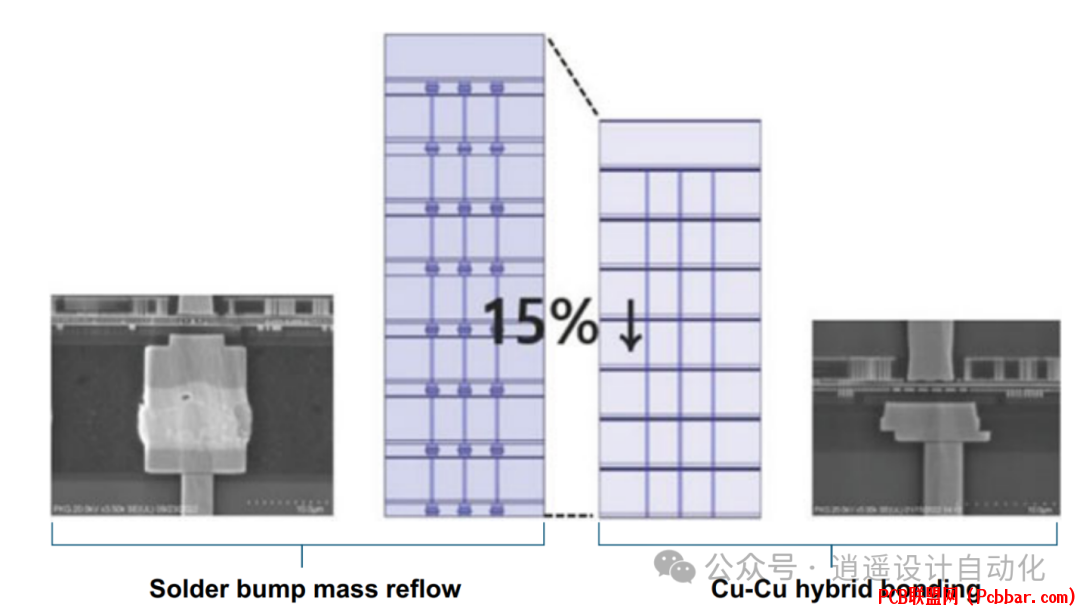 9 ~7 v/ o1 S) g& G
9 ~7 v/ o1 S) g& G
图6:8Hi HBM的焊料凸点倒装芯片和混合键合互连结构对比,显示使用混合键合可减少15%的厚度。
3 b9 z7 D# w8 c C N- s1 N* `; ]. W5 r, l v+ G
SK海力士的工作集中在优化等离子体处理和键合条件,以实现高键合强度和低空洞密度。+ ^9 h3 R' v% h1 J
/ g! R/ x' j `% k美光
6 L. ], Y) O( k2 l2 k# D! P% h( Q美光正在开发用于HBM和潜在3D DRAM应用的混合键合。他们强调了几个关键挑战,包括:
7 g% D# K0 ^+ T% L" G6 i/ j晶圆切割后的颗粒控制传统晶圆支撑系统的限制需要更高温度的退火
! c7 p, @+ M- O! s7 A, J: p H
- t1 G& j1 i, u# R M! Z: \
ut314qzm5gx64077136138.png
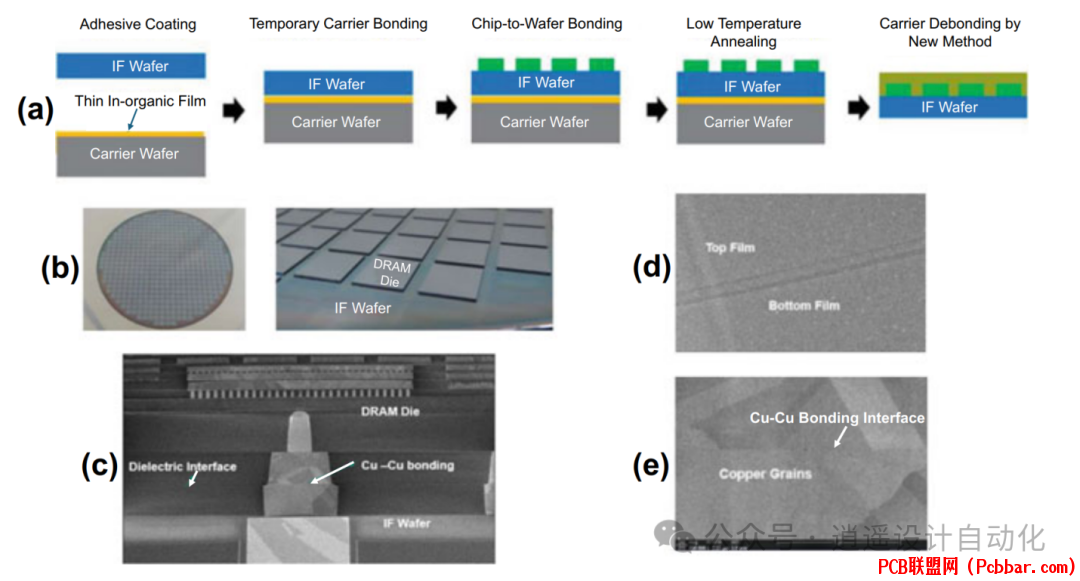
) B$ I( P- q; y' h图7:美光的新晶圆支撑系统(WSS)工艺,可实现更高温度退火,提高混合键合质量。& Q- \" B. P, S) [7 { ]
/ D, H$ ~$ w' A( Q
索尼
9 D8 E5 I$ _& @- Q) [作为CMOS图像传感器混合键合的早期采用者,索尼继续推进该技术。最近的工作集中在:* ^8 E, i1 C. P& F" h% d
大尺寸(>400 mm2)芯片对晶圆键合细间距(6 μm)互连新型结构,如界面处的Cu-Cu布线$ h! r6 n9 X+ ?. m0 [
' m6 Q% v( p7 L
qz54ipfq1mu64077136238.png

+ ^ g$ T; T* s, i* M) ^5 {图8:索尼在键合界面处的新型Cu-Cu布线结构,除了电气接触外,还可将Cu图案用作互连。
7 z+ Z, Q1 U* x, A: b2 t3 y' ~
a, E w) B, q! K应用材料8 A0 F" D5 |. z4 v! E8 S, V
作为主要设备供应商,应用材料正在开发先进节点的混合键合工艺和工具。最近的工作展示了:
, Q$ [$ D& [2 j" [$ j0.5 μm间距的晶圆对晶圆键合 使用SiCN作为键合介电材料Cu凹陷控制在
/ p9 |) o: Y' T1 W/ m# X9 C% w6 \& S
autzd02fnpu64077136339.png
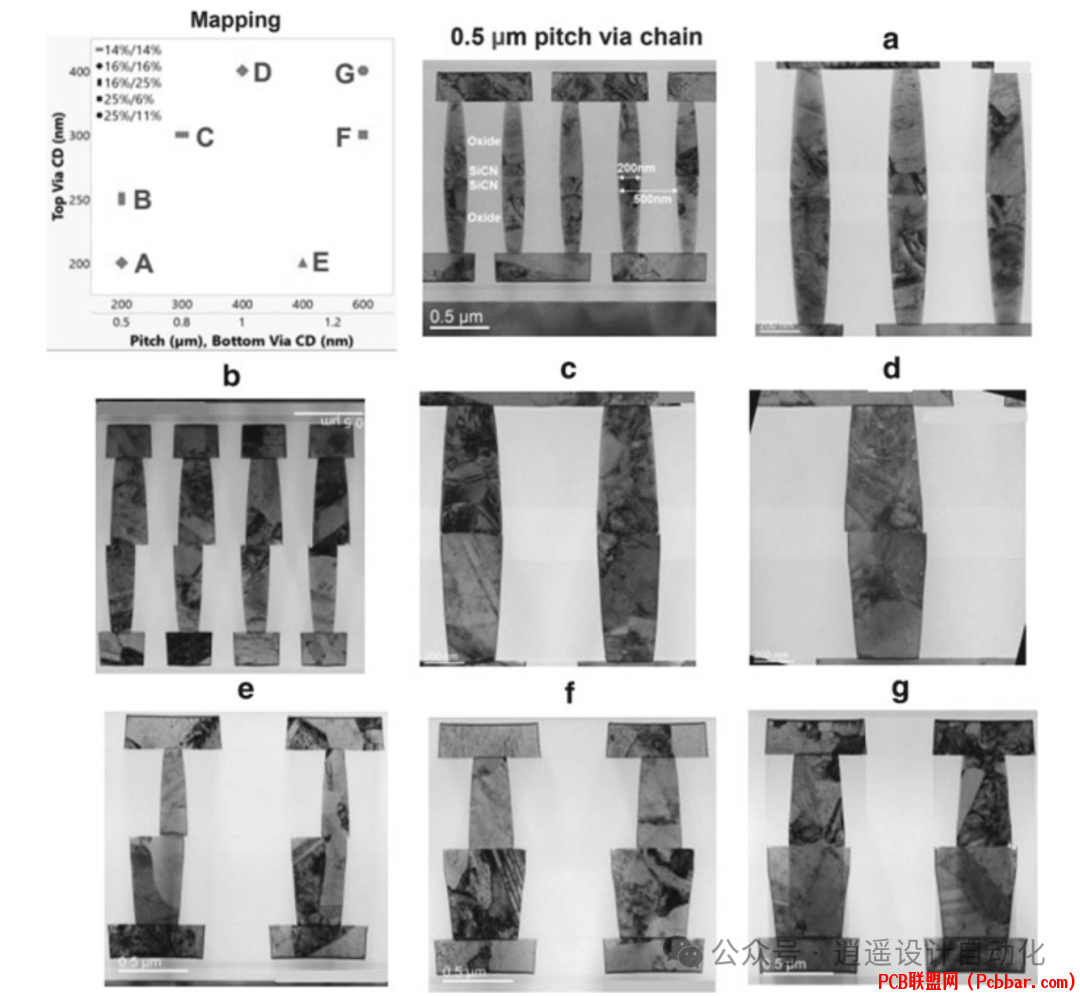
& c+ t j4 I( S$ z/ m图9:应用材料公司展示的各种特征尺寸和间距(小至0.5 μm)的混合键合结果TEM图像。
: m+ v1 I% X' N# x- _3 x
/ H1 Y( `; C# b7 D8 Y* A) j9 y/ X英特尔& n- c& }6 W# V' z3 n+ E
英特尔正在研究混合键合作为其先进封装路线图的一部分。最近的工作集中在:
% v$ r& o4 j6 J* R4 E, ^用于键合介电的低温SiCN薄膜表面活化效果的表征键合强度优化' q! P% `& j6 r2 G3 C% y4 ^
7 X- ]8 N4 o: N
aidcjibsnq564077136439.png

2 I0 V" ?7 \5 M: Q7 u. S图10:英特尔研究中各种SiCN-SiCN键合界面和退火温度的键合能量(强度)结果。
" R# {- {8 @/ a' p5 V! c2 ~) `( c- ?
台积电
( O5 y% x8 l5 O1 n- G- Y, M台积电正在其SoIC(集成芯片系统)平台下开发混合键合。正在推进芯片对晶圆(SoIC-X)和晶圆对晶圆(SoIC-CoWoS)方法。8 m! `$ j+ h8 U* N# A. e
! R9 A- Z( x; @4 C. f q
最近的工作集中在:* E+ P1 E+ D& H: ~5 i1 d3 g: N* I
热管理优化TSV与键合焊盘直接连接超薄键合膜
" z3 |6 \0 w' `. m
+ r; \. q8 k8 l# }5 {
vo4wv4r4kz364077136540.png

+ k# p, c5 I! N y0 T% B3 Q图11:台积电SoIC平台中背面键合界面电气-热协同优化方法。
/ C; {, p% i- c8 t0 A
( s" @2 n# V+ b7 K% ~9 P' u新兴研究方向
) b& L& P0 q9 B- v1 e& e, P正在追求几个有趣的研究方向,以进一步推进混合键合技术:5 D7 m; q w3 N7 [$ J( s
1. 新型键合材料
1 a8 x- ~7 N6 z) N8 }( v. W9 z虽然SiO2和SiCN是常见的键合介电材料,但也在研究其他材料。例如,Resonac提出使用环氧模塑料(emc)和光敏性介电材料(PID)等有机材料进行混合键合。
" J7 H" j* {9 k: o/ z
pudlnifofrg64077136640.png
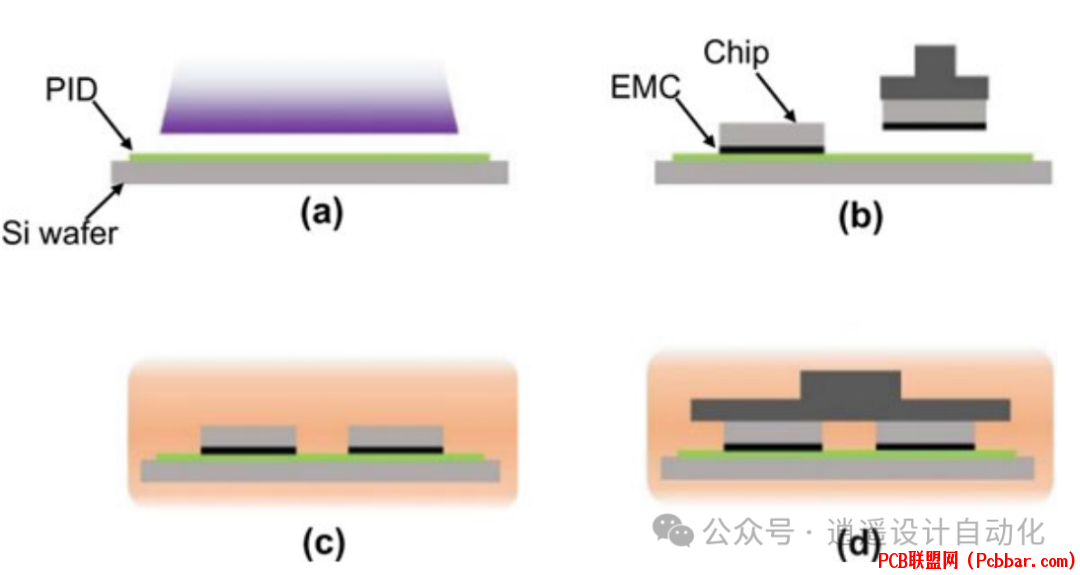 ! [$ P' ?' ^! S3 Z" O+ i! N7 o
! [$ P' ?' ^! S3 Z" O+ i! N7 o
图12:Resonac使用EMC芯片和PID晶圆进行混合键合的热键合工艺。
2 V- l# Y' f: y, Z4 u4 L- ?# b( o( n9 I% l+ L* N) c |
2. 金属间化合物形成
8 C9 t) `9 c- V8 b一些研究人员正在探索在键合界面处控制形成金属间化合物。例如,德累斯顿工业大学的工作研究了用于混合键合的超薄Cu-Sn双层。
Z% F3 @' `5 y" v" m$ s
xk11pdxggni64077136740.png

. Y" b% N: Y2 X; i& a; Z7 m; G; [图13:不同退火温度下超薄Cu-Sn双层的金属间化合物生长研究。
- e# s# F, S' D5 W. I1 j C* s* N' M5 F- w' D& D0 D: Q7 M
3. 新键合机制
3 l1 g& k' c4 Z9 o+ `; {IMEC报告了一种"Cu鼓包"机制,可实现亚微米间距的混合键合。这涉及在退火过程中控制Cu扩散以填充界面处的小间隙。0 k: R7 Q: ]8 Z- s
thvhe5pknz264077136840.png

3 a; [: n; v" @图14:IMEC的Cu"鼓包"机制支持亚微米混合键合的TEM横截面图。9 m9 j" x( ?' L% g7 \/ C) Z
9 x* \/ i+ w$ _5 {* J, `4. 替代键合方法
3 O$ {" W/ h- ^! h3 y3 X虽然大多数混合键合工作集中在室温下的氧化物对氧化物键合,然后退火,但也在探索一些替代方法。例如,加州大学洛杉矶分校提出了一种两阶段热压缩键合(TCB)方法,简化了工艺。
) t8 L% {6 ~4 ` s
3zne1lf2fee64077136941.png
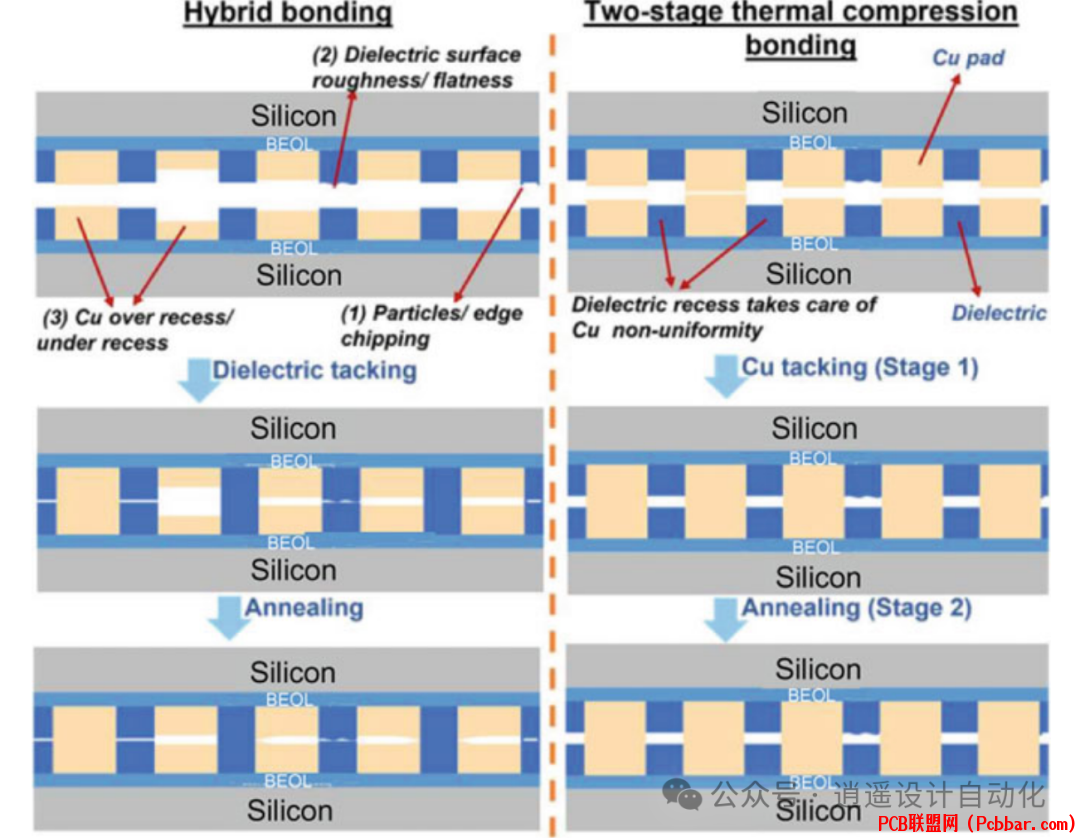 - u) x% y8 K: z1 B+ l8 t f3 `
- u) x% y8 K: z1 B+ l8 t f3 `
图15:传统混合键合与加州大学洛杉矶分校提出的两阶段Cu-Cu TCB方法的比较。
5 v, ]) m" S8 ~$ f2 k3 f ^# @3 l u8 \1 o. J! ]) x
结论
, f% e6 D& i1 z1 |Cu-Cu混合键合正在迅速发展成为下一代3D集成的关键技术。主要的存储器和逻辑制造商,以及设备和材料供应商,正在积极开发和优化混合键合工艺。主要关注领域包括更细间距扩展、更大尺寸晶圆/芯片键合、新型材料系统以及与先进节点器件的集成。( w% C8 y7 ~' q5 z8 {# H% }
$ s# p3 B) U# |/ b9 ?& s
取得了重大进展,但仍然存在几个挑战,特别是在表面准备、对准精度和缺陷控制方面。需要在材料、工艺和设备方面继续创新,以实现混合键合在广泛应用中的大规模制造。
8 p, Y6 x) c/ U3 b, ^5 b4 F- O; `) M+ w: S1 a ?- R
随着半导体行业不断推动更高水平的集成和性能,Cu-Cu混合键合将在实现先进3D和异构集成方案中发挥关键作用。未来几年可能会看到混合键合在需要超高密度互连的存储器、处理器、传感器和其他应用中得到更广泛的应用。
* Z4 R& V0 q( F' e8 v. W( y+ d8 |3 |$ u/ H# J7 g' q: o' o
参考文献
& M% C: |8 H+ c* b- H2 X[1] J. H. Lau, "Cu-Cu Hybrid Bonding," in Flip Chip, Hybrid Bonding, Fan-In, and Fan-Out Technology. Singapore: Springer Nature Singapore Pte Ltd., 2024, ch. 2, pp. 103-157.
! d* `9 ]: D7 p% J$ q4 B
! A- A! U4 h: ^+ r, V1 w- END -) _$ c6 C% z( Y/ P- ^: G
) B* A9 ?1 @3 \) n9 ~: r+ s7 X* G+ k软件申请我们欢迎化合物/硅基光电子芯片的研究人员和工程师申请体验免费版PIC Studio软件。无论是研究还是商业应用,PIC Studio都可提升您的工作效能。
" _( r, d) ]% p& E: I点击左下角"阅读原文"马上申请% Y2 d2 C% z: `6 W5 r, ~7 e
/ }" L8 Z% P; M; w1 N
欢迎转载! ?( w: l! y( O9 P3 Y0 V
5 z5 t1 ?* o2 b. ?5 w
转载请注明出处,请勿修改内容和删除作者信息!9 x: o& V( }2 p
' m7 m# w$ q2 |$ A3 [' ~
( a% {. g3 J) r: ^& C+ @
) |6 _0 C/ t7 T4 R* G4 o7 {+ n9 P2 b
5due4j444cq64077137041.gif

$ S# A: L- t, e' b: Y
8 @; w6 D7 n5 ]6 g) h; r) S: g关注我们7 z) j% \! N& ?2 Q) q
1 L8 \0 s! q3 f6 `3 ~# A9 K
& s3 ~4 n5 K* F: Y/ I
oeb4nz0vbrw64077137141.png

$ M( e6 Q* w, S | $ M) S6 w( r3 C, {
dornzbj31cp64077137241.png
 # ?- u c9 [& y4 h1 ^0 i4 w
# ?- u c9 [& y4 h1 ^0 i4 w
| . ~" m3 `; D6 L8 y0 v% {/ z
zpopyimtqka64077137341.png
 5 q# }0 v. [2 B% T/ E w$ O" q
5 q# }0 v. [2 B% T/ E w$ O" q
|
/ N: C9 z& O" ~0 z9 k0 M
% A& a% i0 a) h [% j
9 M. n$ [* Z( u; g, r3 x- o4 Z0 C8 G% w' v$ i" F
关于我们:
: L* ]- I* T9 C* f+ J7 ^8 T深圳逍遥科技有限公司(Latitude Design Automation Inc.)是一家专注于半导体芯片设计自动化(EDA)的高科技软件公司。我们自主开发特色工艺芯片设计和仿真软件,提供成熟的设计解决方案如PIC Studio、MEMS Studio和Meta Studio,分别针对光电芯片、微机电系统、超透镜的设计与仿真。我们提供特色工艺的半导体芯片集成电路版图、IP和PDK工程服务,广泛服务于光通讯、光计算、光量子通信和微纳光子器件领域的头部客户。逍遥科技与国内外晶圆代工厂及硅光/MEMS中试线合作,推动特色工艺半导体产业链发展,致力于为客户提供前沿技术与服务。6 ^' e4 _, J5 D
6 e5 v! A7 `* z" k+ g [2 ?' qhttp://www.latitudeda.com/
, ?" F: S" n# S( ^# R(点击上方名片关注我们,发现更多精彩内容) |
|