|
|
引言
- k9 |8 s# K1 S9 u6 S: G }: y在 SEMICON Taiwan 2024 上,业界领袖齐聚一堂,讨论了封装技术的最新进展。本文探讨会议重点,关注三个关键领域:晶圆上芯片封装(CoWoS)、扇出型板级封装(FOPLP)和玻璃基板技术[1]。
, U. G# ?+ W; I; c! R! }0 v
4 t5 m/ ^5 K0 {. U% i G( BCoWoS:突破集成的界限' F! i% b8 p+ \; b! Q: ^
台积电作为半导体制造领域的佼佼者,一直走在 CoWoS 技术开发的前沿。CoWoS 是一种 2.5D 封装解决方案,允许在单个中介层上集成多个芯片,从而为 AI 和 HPC 应用提供更高的性能和更低的功耗。
8 J$ [9 n# E- j- _1 @0 U/ \2 F/ d
" X3 L# s g6 Q' s. X" \8 g3 @5 |
04hoe2ijr256402435502.png
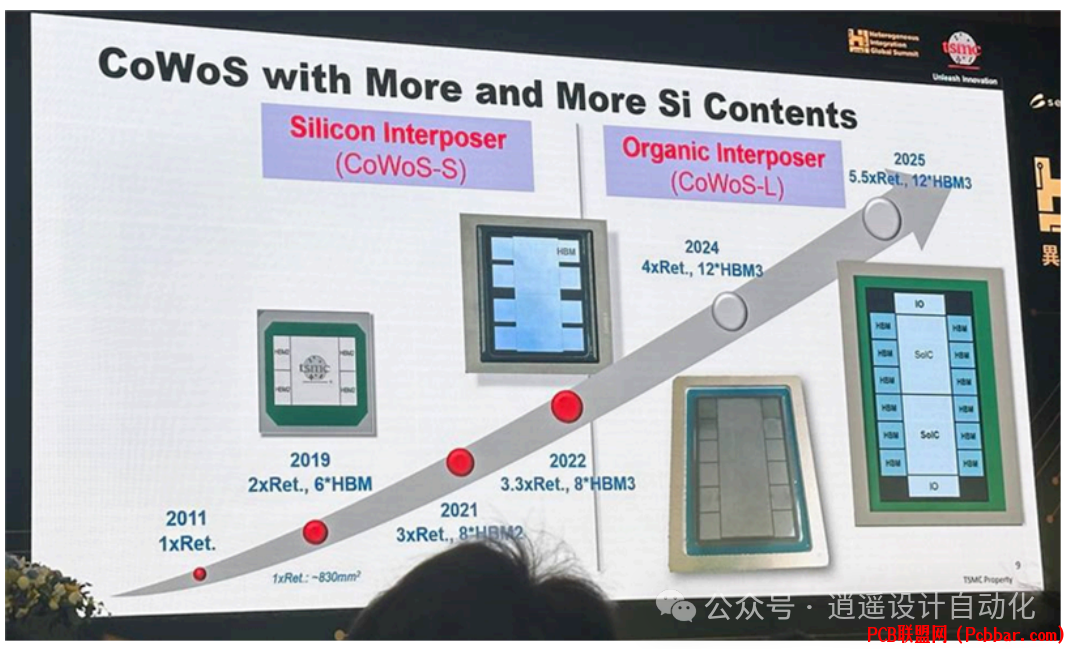 9 H \* c$ O" B% M$ c$ h, `, u* G
9 H \* c$ O" B% M$ c$ h, `, u* G
图1展示了台积电的 CoWoS 技术路线图,显示了向更大中介层尺寸发展的进程。7 n* A. k1 l! M z$ i
' o/ r- w! @0 ?% g, p N台积电的 CoWoS 路线图旨在到 2030 年实现 8-10 倍光罩尺寸的中介层。雄心勃勃的目标是由对更强大 AI 处理器日益增长的需求推动的。推出了三种 CoWoS 变体:CoWoS-S:标准版本,使用硅中介层,能够达到最大 3.3 倍光罩尺寸。CoWoS-R:使用有机重布线层(RDL)中介层,简化设计流程,缩短集成时间。CoWoS-L:在 RDL 中介层中整合局部硅互连,平衡了硅和有机中介层的优势。
; ^0 _8 G0 \ x$ _$ r[/ol]7 l8 N" O [ E; P2 {
% C# ~% f2 e' p
xa1mpyyihit6402435602.png
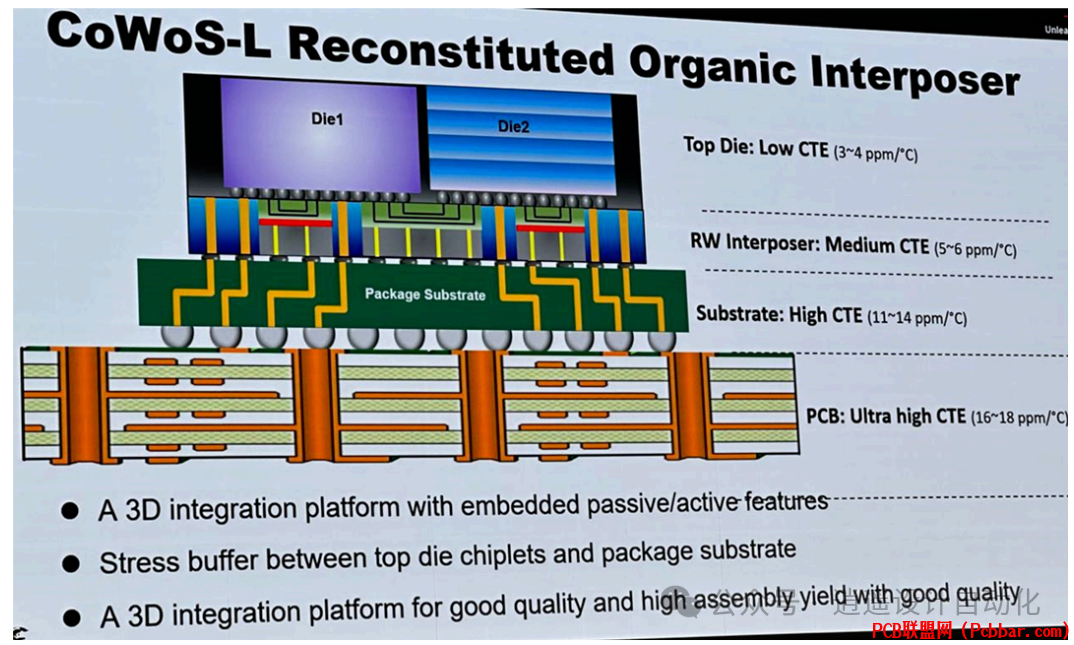
+ V: B4 T1 j& @# c4 }" f* |图2显示了 CoWoS-L 的优势,结合了硅和有机中介层的优点。) i+ H0 T8 J- z* t3 V
( A/ ~! K, z" }# Y
CoWoS-L 预计将成为未来几年最强大的解决方案,台积电计划在 2025 年实现 5.5 倍光罩尺寸的中介层,到 2030 年达到 8-10 倍。这项技术使集成更多晶体管成为可能,并提高了整体系统性能。
# p! {8 ^( }' O' a2 L. ]! C4 X& W$ R: j; x4 f: c2 m
会议还强调了 Chiplet 和 3DIC 设计的优势。这些方法提供:更低的所有权成本减少设计迁移负担改进的分级配对,提升系统性能早期芯片缺陷检测% N$ F. \7 P0 J
[/ol]: ]: P1 E0 M; ]3 C
" c) B7 o1 x3 s; w
un55nfunsnr6402435702.png

1 n6 H! @( j2 k$ Q# j图3展示了逻辑 Chiplet 和 3DIC 设计中分级配对的概念。$ n0 i& ^0 g0 d; j
* ^! p. a; q; Y6 Q3 D% g然而,随着集成水平的提高,良率管理变得尤为重要。台积电强调了高集成良率的重要性,特别是对于在昂贵的先进逻辑节点上制造的顶层芯片。随着集成水平的提高,分割和拾取放置过程尤其具有挑战性。
. T" F5 C/ G# \4 O' W+ }6 b ^1 ^$ e, f- t! Y0 y& _; p- d$ ?
bd5qgtx3mbp6402435802.png
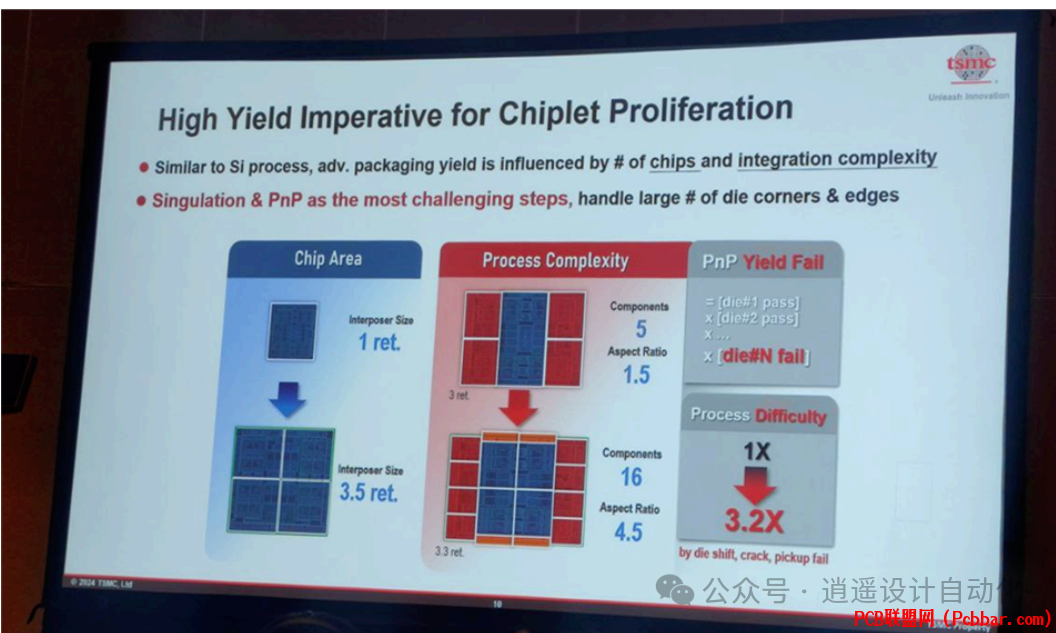
' m. N! {' A( G图4说明了良率对先进封装成本的影响。! E+ _. c' i& R N _
$ r2 `6 U& N) }1 E$ i" C3 z1 ]/ h7 k
为应对这些挑战,台积电呼吁业界支持开发:新型热界面材料(TIMs)有机模塑化合物底填材料先进的过程控制和计量工具
) ?( M1 P8 I3 C0 G9 }0 p$ X% J j[/ol]) c, i/ a: d; ?6 i! Y7 O3 Y
台积电致力于扩大 CoWoS 产能,以满足日益增长的 AI 处理器需求。到 2026 年底,台积电的 CoWoS 产能预计将达到每月 9-10 万片晶圆,相比 2024 年底预期的每月 3-4 万片晶圆有显著增长。
; A! z( _# y6 J/ e, ` E& C
9 d. S" O, P% b* g0 w' t! T+ d5 J6 j扇出型板级封装(FOPLP):未来的扩展方案3 I# B: I0 E$ E: F
随着中介层尺寸不断增大,业界正在探索板级封装解决方案,以提高产出并降低成本。FOPLP 相比传统晶圆级封装提供了几个优势:更高的产出:对于相同的中介层尺寸,600x600mm 的面板可以容纳 8 倍于 12 英寸晶圆的中介层数量。成本降低:板级处理在大批量生产中可以带来显著的成本节约。灵活性:FOPLP 可以适用于各种应用,从边缘设备到高性能处理器。6 o3 y! p8 W& C7 {3 e4 i
[/ol]8 X d8 h8 E1 A3 f; B
& s; K$ M: ]; o$ J0 R2 [0 k! O) o
dlxs2zhrag06402435903.png

8 M3 l6 V/ ]# G. ?: V1 p图5比较了 600x600mm 面板与 12 英寸晶圆的中介层容量。# s! b7 j0 r( l+ t- K6 A" q) d
& D, e+ |( q- L& q/ I ~日月光作为半导体封装和测试领域的领导者,在 FOPLP 技术上取得了重大进展。已经展示了:良率良好的 600x600mm 板级封装有效的翘曲和断裂控制5μm/5μm RDL 线宽/间距能力计划在 2025 年前开发 2μm/2μm 原型2 L: D+ X- M/ E" U/ B. h) h: \
[/ol]
0 s/ t& F! m+ M然而,业内专家认为,FOPLP 在高性能应用(如 GPU 和 CPU)中的采用可能要到 2026-2027 年才会最早发生。这种延迟是由于:现有产品路线图专注于扇出型晶圆级封装(FOWLP)技术,如 CoWoS已分配的 FOWLP 开发资本预算需要面板形状因子标准化以加速开发努力并降低成本
0 Q% Q4 O% M! W2 u5 \9 x; T[/ol]
; ?' z4 N4 |7 {% t" \* p$ i9 f; t* D; q5 G2 ?1 G7 Z, \
w0z0wwppkop6402436003.png

~ B' x) @! m1 I5 K图6概述了日月光对 600x600mm 板级封装解决方案的目标。
' w9 i3 E, i8 t0 _: M" T: r) b5 q1 L5 k9 _
为促进 FOPLP 的广泛采用,业界领袖呼吁:面板形状因子的标准化工具制造商和材料供应商之间的合作加速设备路线图提高工具能力和良率
( E: h$ H* ~8 u: m[/ol]
) L9 t; P' ~' @% n' E; h" k# m/ B2 Q5 O( K4 F% L( x
玻璃基板技术:下一个前沿
- o+ p' r2 e* Q, C* J) SFOPLP 继续发展,但业界也在探索玻璃基板技术作为有机 RDL 中介层的潜在继任者。玻璃基板提供了几个优势:更好的电气性能更精细的 RDL 能力更低的热膨胀系数(CTE)
; P- `3 ^1 x, J0 j7 x. C[/ol]
( R! Z& `% h/ r) n! |- V英特尔在玻璃基板开发方面处于领先地位,这是由于当前 RDL 中介层解决方案的限制以及对更精细凸点间距的需求所驱动的。然而,玻璃基板技术面临几个挑战:脆性:玻璃比传统基板材料更脆,难以加工。制造复杂性:形成穿透玻璃导孔(TGV)需要先进的蚀刻和沉积技术。设备限制:必须开发新的工具和流程来有效处理玻璃基板。
# E# v% O: a- D. R+ T3 J[/ol]2 j" O0 S2 k% Q R8 m
/ b/ ?# H" X. }; y0 }5 O! v- h5 P
djdorix2ok26402436103.png
 ! W& d0 n0 C. O& G; [8 w
! W& d0 n0 C. O& G; [8 w
图7概述了玻璃基板在先进封装中的优缺点。
" y5 i6 n1 p3 H1 a1 @) [$ P1 X# e+ o3 i% z) O
尽管存在这些挑战,玻璃基板在各种应用中显示出潜力,包括:桥接芯片深沟电容(DTC)集成无源器件(IPD)光电共封装(CPO)
6 e+ A6 B, n, b[/ol]
2 g- L9 \: I2 o9 P$ Z1 v7 S5 _/ N业内专家预测,玻璃芯基板可能在 2027-2028 年左右进入大规模生产,紧随高性能应用中 FOPLP 的采用之后。
9 L* E, j! S8 [* a! k1 {7 F+ ]# q3 d. _+ T A% h
结论
' w6 w" Z/ ~% J" y先进封装领域正在快速发展,以满足 AI 和 HPC 应用的需求。CoWoS 技术继续推动芯片集成的界限,台积电在更大中介层尺寸方面领先。FOPLP 为扩大生产规模和降低成本提供了有希望的解决方案,但需要标准化和设备开发来加速采用。玻璃基板技术代表了先进封装的下一个前沿,提供了改进的性能和更精细的 RDL 能力。
$ @; E7 I4 m2 }$ O' |! w) l# e
4 w2 c3 ]! K) Z' _! I5 h$ I随着这些技术的成熟,半导体生态系统各方的合作将变得非常重要。设备制造商、材料供应商和芯片设计者必须携手合作,克服与每种封装方法相关的挑战。通过这样做,行业可以继续提供必要的性能改进,推动 AI、HPC 和其他领域的创新。
4 u! @5 ^/ K. F/ F+ h- V& K* Y/ `1 _ J8 I
1 |6 l0 h& K+ s" \4 A2 w' j
参考文献
$ i. C. E6 M9 q, }- n[1] Jeng, D. Teng, and V. Yang, "Greater China Semi: CoWoS, FOPLP, and glass substrate - Key takeaways from SEMICON Taiwan 2024 |# h9 P4 E1 p! p5 o
+ g5 j4 a- U& Y3 O- T* G1 [3 n/ `
- END -
) X# l: t2 J- F% D: t8 ~' o! t; @* H2 ?7 A& a0 `
软件申请我们欢迎化合物/硅基光电子芯片的研究人员和工程师申请体验免费版PIC Studio软件。无论是研究还是商业应用,PIC Studio都可提升您的工作效能。8 h3 R R) x+ d; o# R; l) _9 s
点击左下角"阅读原文"马上申请
0 D0 i! r7 `0 F9 B; z4 g6 P1 c/ P; j
欢迎转载
1 ^0 T; r, Y; q [* c
/ h3 h M# `/ H5 S" l转载请注明出处,请勿修改内容和删除作者信息!
8 J1 K* `" x: d2 T5 J: W% t; n
; t! J: T! B' Y, N6 t$ e6 a0 U7 ~2 O r2 q+ S9 V9 v) o& D9 {$ g2 G
: G$ z4 I8 P, S8 B! K" Y {5 l
fzsatln4reo6402436203.gif
 9 b+ A7 O7 @! m% I' ]+ k# P
9 b+ A7 O7 @! m% I' ]+ k# P
% [0 R- K2 ^. w; \
关注我们
' {, `4 l0 L7 Y+ b; K" R& j
2 a9 ~( a+ s8 ^
* v' }! D! a/ x$ x2 [5 Z Q
jxnumiu25xu6402436303.png
 5 y3 O9 r5 L; n- _
5 y3 O9 r5 L; n- _
|
; l$ k, y) w. w+ ~& Z
ktd3mheetyv6402436403.png
 3 B3 L) j! {, K! ?2 a n5 N5 e/ P
3 B3 L) j! {, K! ?2 a n5 N5 e/ P
|
4 H: l! N0 `: f' q' P, l/ E+ v
vxwlhu1lc1l6402436503.png

0 K# ^, J7 T+ W |
1 }2 C( g8 C, x* \4 g
! h* X T* n( K3 {' _ [5 M
% e: ]$ g6 @+ ~6 Q* _$ Q
/ U$ A8 X1 G! R. r关于我们:
; H8 w- L _9 [) m% P: x& X9 B深圳逍遥科技有限公司(Latitude Design Automation Inc.)是一家专注于半导体芯片设计自动化(EDA)的高科技软件公司。我们自主开发特色工艺芯片设计和仿真软件,提供成熟的设计解决方案如PIC Studio、MEMS Studio和Meta Studio,分别针对光电芯片、微机电系统、超透镜的设计与仿真。我们提供特色工艺的半导体芯片集成电路版图、IP和PDK工程服务,广泛服务于光通讯、光计算、光量子通信和微纳光子器件领域的头部客户。逍遥科技与国内外晶圆代工厂及硅光/MEMS中试线合作,推动特色工艺半导体产业链发展,致力于为客户提供前沿技术与服务。
/ R3 T( ~1 O0 K C0 y! X: R8 M- i
4 s5 G( e V, ?6 X7 K9 s5 lhttp://www.latitudeda.com/4 @# ?) u$ x) Z6 S+ e+ m
(点击上方名片关注我们,发现更多精彩内容) |
|