引言4 W* T/ m1 H7 L$ S0 {% e
在人工智能(AI)计算领域,传统制程缩放正面临局限性,同时业界对现代AI硅基封装(SiP)中逻辑、存储和模拟线路的高度集成需求持续增长。针对这些挑战,Broadcom开发了3.5D eXtreme Dimension SiP (XDSiP?)平台。通过Face2Face (F2F)技术将2.5D技术与3D-IC集成相结合,为下一代定制加速器(XPUs)和计算ASIC的开发提供了新的解决方案[1]。
% @5 K( u' Y* n* p Q
0cqmiqp35dj6401579432.png

" ^; b( A6 R2 ?, T
; L6 T l/ i0 L9 Y7 q( g, ]. P: Z. L7 o$ `* b
iufq0udrg0p6401579532.jpg
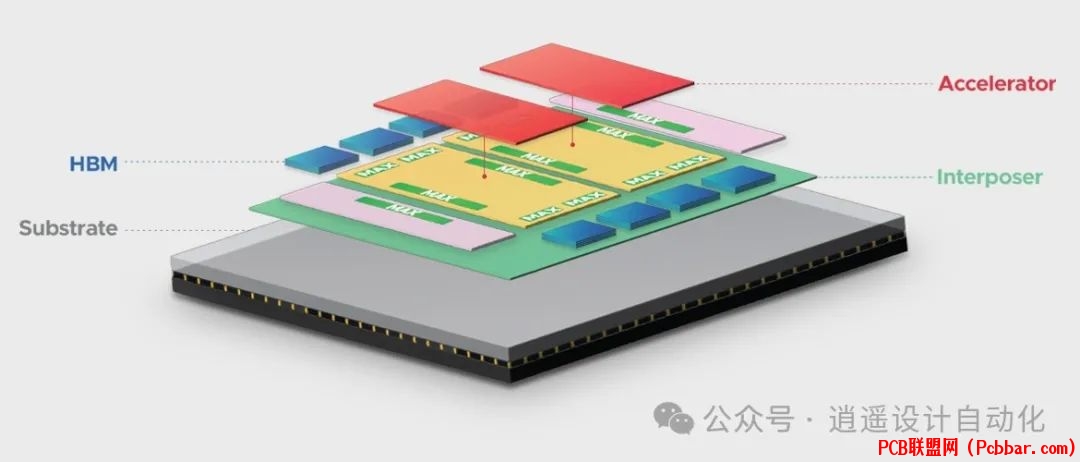 : V% d* ]* X: b& M4 K
: V% d* ]* X: b& M4 K
l54vtjwqdzg6401579632.jpg

, V$ e: a4 U5 y& v4 N图1:Broadcom的3.5D XDSiP平台技术,在推动AI基础设施发展中的作用,具备开放性、可扩展性和高效能的特点。* m$ n2 u5 q6 v8 [3 [( L8 G( d6 R
% n3 g$ d. K2 e
历史进程与复杂度增长, T- V; j, W5 @9 z
AI加速器的发展历程跨越十多年,每一代技术都带来新的能力和挑战。从2014年的初期发展到2026年以后的预期进展,这一领域经历了持续的技术升级。
, ]0 f2 v: V9 s: l1 p9 e7 A
rn3pn5rchth6401579732.png

* N" ^8 l+ Y& N6 G# M- W图2:Broadcom从2014年到2026年及以后的多代定制AI加速器发展历程: g1 T" H0 t+ I3 P
$ j1 p+ o3 b% ] L* [) j5 \消费级AI XPU的复杂度呈指数级增长,这种增长由多个相互关联的因素推动,包括计算性能、网络带宽、存储带宽、供电能力、散热完整性和机械可靠性等。, Z% m" t! N2 f' S6 X: {. _
tt1hfocmeha6401579833.png
 5 ^4 `; _" k/ j, P6 a$ j) G
5 ^4 `; _" k/ j, P6 a$ j) G
图3:2014年至2028年消费级AI XPU复杂度的增长趋势,气泡大小代表XPU设计日益增加的复杂程度。" L3 ~* l8 ] k9 w/ _9 m6 f: A1 I" B
7 ? K0 S: }4 g7 d5 v0 I技术挑战与解决方案
7 L% Y$ `) a* S" J3 t" H/ c1 x半导体行业面临传统制程缩放放缓的重大挑战。尽管性能和功耗缩放继续推进,但逻辑和SRAM缩放已显示出局限性。/ @1 O1 q5 O1 l, M: B9 u- F
3veesndrn526401579933.png

3 Q; w/ b- O9 U% ]: Q图4:不同世代之间逻辑缩放、SRAM/IO缩放、性能和功耗之间的关系,说明了制程技术发展趋势中的挑战。9 L+ m/ W& r4 C% V& c
5 p6 l. Q' c! i- f# p) N
3.5D XDSiP架构通过创新方法解决了这些挑战,结合了2.5D和3D集成技术的优势,在性能、功耗效率和形态系数方面实现了显著提升。
" @# Z- o" ]0 d/ |* E
jt4gvy1b5zo6401580033.png
 % j3 _5 t: d1 F( d
% j3 _5 t: d1 F( d
图5:从2.5D XPU ASIC到3.5D XPU ASIC的转变,突出了在内容密度、封装尺寸、成本和性能方面的改进。. U5 n8 q2 q3 m U5 ^
6 _& P6 i. Z# ?% j5 \
Face-to-Face技术实现
/ |( c* R8 N9 _$ Q( Y3.5D XDSiP中的Face-to-Face (F2F)技术较传统的Face-to-Back方法实现了重大突破,在信号密度、性能和设计灵活性方面带来了实质性提升。
8 @' W' [5 S4 k: y2 M
kgzhmlw2kx06401580133.png
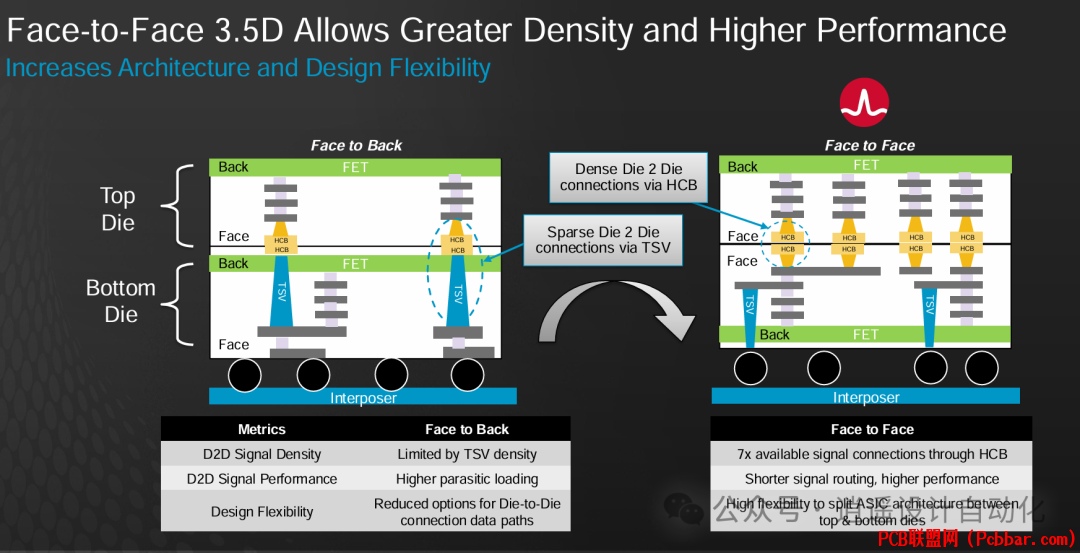
4 E% Y: e/ N3 H2 l4 d4 p0 q7 k! T( P$ [7 g图6:对比了Face-to-Back和Face-to-Face 3.5D技术,展示了结构差异和性能优势。& q2 o$ l1 `& ]" M4 \+ u
$ L3 j" _0 r3 y+ E9 Z* ^2 z0 nF2F方法相比传统方法实现了多项关键改进:堆叠裸片之间的信号密度提高了7倍,通过更短的布线路径和更低的寄生负载提升了信号性能,在顶部和底部裸片之间的ASIC功能分配方面提供了更大的灵活性。 c! s5 R/ x0 q( |
3 ^! I& t; K+ c1 V7 n1 v% Z
现有应用和未来发展3 M) a% d( D9 M: ]9 |' x
Broadcom已开发了多种3.5D XDSiP技术实现方案,以满足不同的计算需求和应用场景。
$ N/ O7 m0 f9 y4 Q2 ~
ja4mxk3db2c6401580234.png
 + K; T3 v: [5 F- s& J( i- \) n% Q p
+ K; T3 v: [5 F- s& J( i- \) n% Q p
图7:不同的3.5D XDSiP定制XPU开发实现,每种实现都具有独特的规格和性能。/ N8 }$ z% P0 K1 B% Z
" k/ I4 G' W: _3 V# s& i" D5 p3 |这些实现方案包括具有不同数量3D堆叠、I/O chiplet和存储解决方案的配置。第一种实现采用双3D堆叠,配备十二个HBM3模块,采用100x100封装,其他版本则根据特定性能需求采用不同的堆叠、chiplet和存储技术组合。' n; l Z$ C2 S
4grpexwqtuw6401580334.png

, u/ K- [0 Z7 u% q. S1 A& x图8:Broadcom 3.5D XDSiP技术的主要成就,包括行业创新、缩放能力和开发时间表。4 u$ G' r$ F( f/ L/ K/ n
. J2 b7 H! g. x: E技术优势和市场影响
3 @+ n& Z& m$ d3 N3.5D XDSiP技术在多个性能指标上实现了显著提升。在互连密度方面,信号密度较此前方案提高了7倍。通过使用3D HCB技术替代平面裸片间PHY,裸片间接口的功耗降低了10倍。该平台还显著降低了3D堆叠中计算、存储和I/O组件之间的延迟。0 j/ P1 u( ]; o5 U8 p: P
5 W: G% W% ~" k7 J& f- ?
这项技术实现的紧凑型封装带来了更小的interposer和封装尺寸,降低了成本并改善了封装翘曲控制。更为显著的是,该技术突破了以往的缩放限制,能在单个封装中集成超过6000平方毫米的硅面积和12个HBM。
, U) h, P% G" ] Q) [3 g* j+ N' ^1 s* u2 K' }4 O0 S- t' u( e
展望未来) K- s$ ]1 J P3 H2 }" t
随着AI计算的持续发展,对更强大、更高效解决方案的需求将继续增加。Broadcom的3.5D XDSiP技术计划于2026年初投入生产,在应对这些挑战方面迈出了重要一步。该平台通过结合先进封装技术和创新设计方法,为未来AI计算解决方案奠定了基础。这项技术的影响不仅限于当前应用,还为AI加速和计算架构的未来创新确立了新标准。3.5D XDSiP平台代表了AI计算架构演进的重要里程碑,将推动新能力和应用的发展。
2 b7 I( w! X4 y! b9 p
, w, t% T# s9 L9 L! s& {& ?参考文献
8 P, a+ V, v& ?6 y[1] Broadcom Inc., "3.5D XDSiP Platform Technology - ASIC Products Division," Broadcom Technical Documentation, Dec. 5, 2024.
) S- c% ]% I( T; b; @% v& y" o- H- r4 y- e7 j! D4 P. s
END$ }/ O( T3 q. ]1 P; _& W
. W2 M2 d# W3 J) ~; m2 h" q% e! t0 L3 ?
& x# O; x- X7 E; S. n+ d& @* ?
软件申请我们欢迎化合物/硅基光电子芯片的研究人员和工程师申请体验免费版PIC Studio软件。无论是研究还是商业应用,PIC Studio都可提升您的工作效能。
5 M* O. w |% y4 {点击左下角"阅读原文"马上申请
/ l% e/ H4 {* o. O. _% ]( t( L8 w$ V' E
欢迎转载
Y. R Y) _5 p; }0 w# n: Z$ S; C- |1 |* A8 S+ A9 Q! S# d# q
转载请注明出处,请勿修改内容和删除作者信息!% c9 s' [, S2 d# K. Z
# N: W5 D3 `7 V2 b5 G1 Z: J) P T
. H# ?* o/ ~+ F6 l+ F
; g# P* g2 c3 }, q0 f6 m) x4 g8 v/ N
fzi31mz0cxa6401580434.gif
 , Q9 g: S: ]6 Q) Q
, Q9 g: S: ]6 Q) Q
+ Q7 t; x5 y5 x( j" w5 C. o
关注我们- O0 {% j& p" G! G4 Z# H
, A6 K8 U5 Z; R) v( l4 c* H. D6 P0 Z) U c& y8 P1 r8 W
5p0qrun53sn6401580534.png
 . v" O7 Z/ s4 Y* ?, J7 K9 i
. v" O7 Z/ s4 Y* ?, J7 K9 i
| . v) h0 t2 P) k# e) o( G! `7 ~
djkeh2kggpy6401580634.png
 9 r/ X9 P$ }: n( v7 S
9 r/ X9 P$ }: n( v7 S
| ! r0 L1 h5 W( V+ R+ P3 A9 O! N
e0iincdnb5y6401580734.png
 8 p$ w- Y8 L/ ~2 W, t
8 p$ w- Y8 L/ ~2 W, t
|
. f% W. o' ~5 G" F* _' h
# W8 d! U, B( Z" |! v! c, x8 G i9 G# z* ^
! ?9 J" i: `& F! I* Z: n) B关于我们:' x3 y: s, [2 A
深圳逍遥科技有限公司(Latitude Design Automation Inc.)是一家专注于半导体芯片设计自动化(EDA)的高科技软件公司。我们自主开发特色工艺芯片设计和仿真软件,提供成熟的设计解决方案如PIC Studio、MEMS Studio和Meta Studio,分别针对光电芯片、微机电系统、超透镜的设计与仿真。我们提供特色工艺的半导体芯片集成电路版图、IP和PDK工程服务,广泛服务于光通讯、光计算、光量子通信和微纳光子器件领域的头部客户。逍遥科技与国内外晶圆代工厂及硅光/MEMS中试线合作,推动特色工艺半导体产业链发展,致力于为客户提供前沿技术与服务。* G! s- b: L& Y5 ~, ]) q5 s
2 b( o! b0 [+ z0 G4 x3 T' N
http://www.latitudeda.com/$ }7 @1 J% l! e B& [: B7 d
(点击上方名片关注我们,发现更多精彩内容) |